人工智慧(AI)、高效能運算(HPC)已成為推動半導體產業成長的核心驅動力,由AI跟HPC帶來的技術需求,正在引領整個半導體產業的技術發展方向。在先進封裝領域,高功率與大尺寸的趨勢愈加明顯,不僅改變了晶片封裝與測試的方式,也為供應鏈帶來前所未有的機會。在今年SEMICON Taiwan展會上,面板級封裝(FOPLP)成為業界熱議焦點,各種針對AI晶片與功率元件的測試解決方案,無不反映產業正全力迎向這場變革。
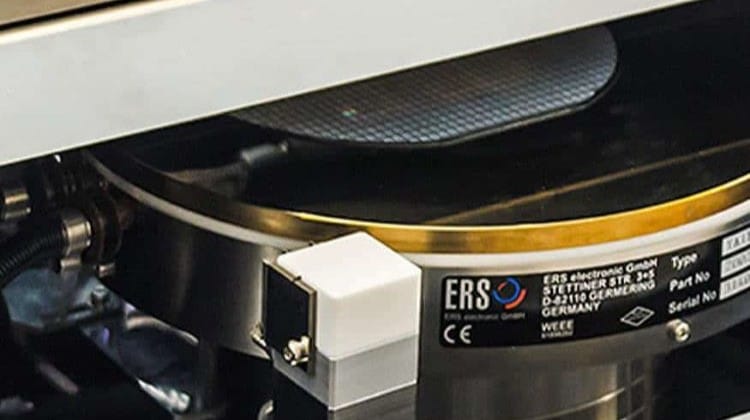
AI與HPC應用的持續升溫,使GPU與AI加速器的規模與功耗不斷增加。如今,單一GPU模組動輒千瓦級功耗,對測試設備的溫控能力提出嚴峻挑戰。不僅如此,氮化鎵(GaN)、碳化矽(SiC)等第三類半導體在電源領域的滲透,也進一步推升封測業者對高電壓、大電流測試的需求需求。這類寬能隙材料,正快速進入電動車、快充、工業馬達等高壓大電流應用,其晶片在測試階段同樣需要能承受高電壓、強電流的探針卡盤系統。無論是AI晶片還是功率元件,都讓高功率測試成為新時代封裝不可避免的課題。
在製程演進的另一端,大尺寸封裝逐漸成為主流。以面板級封裝(FOPLP)為例,業界看重的是其在成本優勢與多層堆疊的靈活度,能更好地支援高頻寬記憶體(HBM)、CoWoS等複雜的先進封裝。然而,伴隨著基板尺寸放大,翹曲變形的問題也變得更加嚴重,對測試階段的探針接觸精準度造成挑戰。
高功率與大尺寸這兩個發展趨勢,為封測產業帶來前所未有的挑戰,但同時也孕育出龐大商機。誰能在這場轉型中提供解方,便能在競爭激烈的供應鏈中脫穎而出。以晶圓測試用溫控卡盤系統為例,若能支援到2.5kW級別,便足以應付GPU這類超高功耗晶片的驗證需求。再者,能協助封裝測試廠商進行翹曲調整、形變量測的設備,更是確保良率不可或缺的工具。當AI與電動車兩大應用同時驅動市場,設備商的解決方案便直接轉化為訂單與營收。
德國儀艾銳思半導體(ERS)以溫控卡盤與翹曲調整技術聞名,在本屆SEMICON Taiwan展上展示的Thermal Chuck Systems,最高可承受2.5kW測試功率,正好對應GPU與功率元件的測試挑戰;其LumosON光學剝離機則可支援Fan-out、HBM、CoWoS等封裝技術,更切合台灣產業對異質整合的需求。而且,相對雷射剝離製程,LumosON是以閃光燈照射方式實現剝離,因此速度更快,可搭配的接合材料也有更多樣化的選擇性。
ERS執行長Laurent Giai-Miniet透露,台灣已是公司最重要的市場之一。2024年台灣占其營收33%,2025年預期將提升至48%。這個數字不僅反映了ERS的在地深耕,也印證台灣在全球先進封裝供應鏈的核心地位。
AI驅動的時代,封裝技術早已不再只是輔助角色,而是決定產品效能與可靠度的關鍵一環。高功率、大尺寸的封裝需求雖讓測試環節面臨嚴峻挑戰,但也為設備供應商與材料廠商帶來巨大成長契機。台灣作為先進封裝的重要基地,正成為這場變革的前線戰場。從GPU到功率半導體,從FOPLP到異質整合,未來幾年封裝產業的走勢,將深受AI與高效能運算應用驅動。在挑戰與商機並存的賽道上,能精準解決問題的廠商,將是下一波贏家。